橢圓偏振技術是測量檢測薄膜的介電性質(復折射係數或介電函式)、膜厚以及表面形貌的一種光學測量技術。

分析自被測試樣表面反射光束的橢圓偏振狀態的變化,橢圓偏振測量技術可以探測到比測量光線波長還要小的膜厚信息,甚至下降到單個原子薄層的信息。橢圓可以探測復折射指數或介電函式張量,這可獲得基本的物理參數和相關的各種樣品的性能,包括形態,晶體質量,化學成分,或電導率。它通常用來表征厚度為從幾埃(A)或10納米(nm)到幾個微米(μm)不等的單層薄膜或複雜的多層薄膜堆疊,並且具有非常好的精度。
“橢圓偏振技術”的名字起源於絕大多數光線的偏振狀態是橢圓偏振狀態。這項科學技術被科學界掌握利用已經近一個世紀,並且有許多標準的套用實例和商業化儀器。然而,橢圓偏振技術正在引起其他學科,如生物學和醫藥研究人員越來越多的興趣,相關的研究人員發現利用橢圓偏振技術可以實現生物晶片和生物感測器的檢測,並且成像型的橢圓偏振技術還可以和成像表面等離子共振(SPR)聯用。這些研究領域給橢圓偏振技術帶來了新的研究熱點和挑戰,如在不穩定狀態下液體表面的測量和顯微成像技術。
成像橢圓偏振技術
將傳統的橢圓偏振技術的探測器更換成CCD相機可以實現成像橢圓偏振技術。這提供樣品的實時對比度的圖像,它同樣提供了薄膜厚度和折射率的信息。先進的成像橢圓偏振技術以傳統的消光型橢圓偏振法則運行
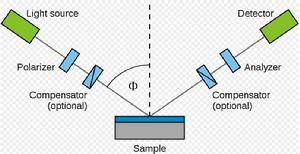 成像橢圓偏振技術原理圖
成像橢圓偏振技術原理圖原位橢圓偏振技術
原位橢圓偏振技術是指對樣品的變化過程進行動態橢圓偏振測量。這個過程可以是,例如,生長的薄膜,蝕刻或清洗的一個樣品。在原位橢圓偏振測量中,可以確定基本的過程參數,如生長或蝕刻率,隨著時間的推移光學性質的變化。在原位橢圓偏振測量中需要考慮一些額外的因素:不像是通常直接曝露在外的非原位測試樣品,原位測試的樣品通常都在各種過程腔體內,檢測需要光線通過這些腔體的光學視窗進行。因此,需要對機械裝置進行調整,其中可能包括增加額外的重定向或聚焦光束的光學元件(反射鏡,稜鏡,或物鏡)。因為過程中的環境條件可能非常苛刻,橢圓偏振測試設定的敏感光學元件必須從熱區分開。最簡單的例子就是通過光學視窗進行檢測,但是要考慮應變導致光學(玻璃)視窗的雙折射,或者使之最小化。此外,樣品可能高溫下進行測試,這意味著光學部件在高溫下不同的光學性質。儘管所有這些問題,作為過程控制技術原位橢圓偏振技術在薄膜沉積和變化等過程中變得越來越重要。原位橢圓偏振儀,可以是單波長或光譜型。光譜型原位橢圓偏振儀使用多通道探測器,例如CCD探測器,同時測量獲得在光譜範圍內各個波長的橢圓偏振測試數據。
優點
比較標準的反射強度測量橢圓偏振測試有很多優勢:
橢圓偏振技術在光譜的每個波長至少測試兩組數據。如果套用廣義橢偏橢圓偏振技術可以在每個波長的測量到16個參數,。
橢圓偏振技術測量強度比而不是純粹光的強度。因此,橢圓偏振技術受光源不穩定或大氣吸收的影響較小。
勿需參比測試。
介電函式(或復折射指數)的實部和虛部分可以同時獲得,而沒有必要進行克拉默斯- 克羅尼格分析。
橢圓偏振技術特別適用於研究各向異性樣品的反射率測量。
成像型橢圓偏振技術由於能夠直接“看”到試樣,對原位橢圓偏振測試和橢圓偏振技術在微結構試樣和生物晶片方面有很大套用。
